先进封装与系统集成解决方案
SCI

先进封装与系统集成解决方案
Copper Pillar Bump Flow
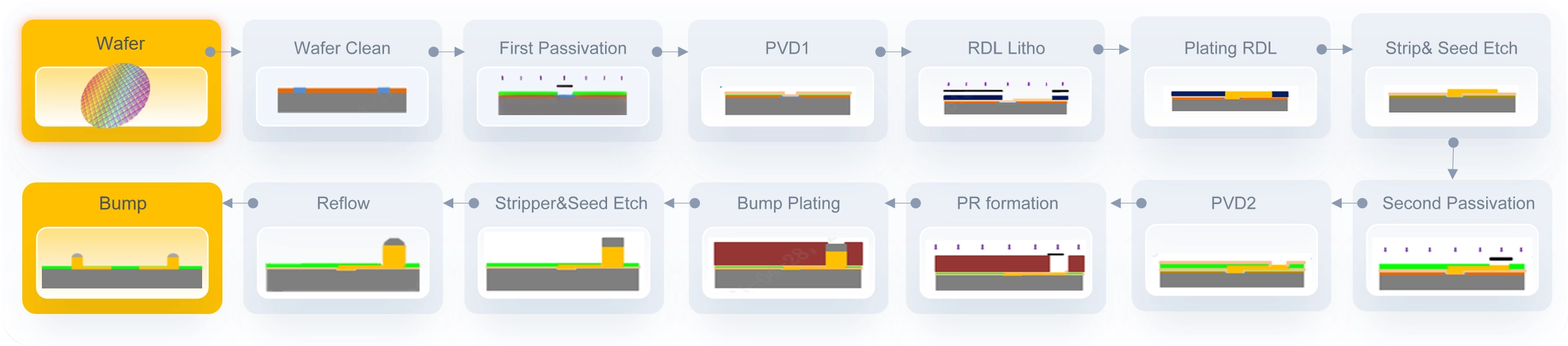
Solder Bump Flow

| Item | 2025-HVM | 2025-NPI | 2026-HVM | 2027-HVM | |
|---|---|---|---|---|---|
| Tech Node | 5nm | 5nm | 5nm | 3nm | |
| Wafer Size(Inch) | 8&12 | 8&12 | 8&12 | 8&12 | |
| Wafer Type | Silicon | Silicon | Silicon,Glass carrier | Silicon,Glass carrier | |
| Notch Type | Notch | Notch | Notch,Flat | Notch,Flat | |
| Mask Layer | 3P3M | 3P3M | 4P4M | 4P4M | |
| I/O Pin Count(Die) | 40000 | >45000 | ← | ← | |
| Bump Structure | Copper Pillar | Cu/Ni/SnAg | Cu/Ni/SnAg Cu/Ni/Cu/SnAg | ← | ← |
| Solder Bump | Cu/Ni/SnAg Cu/SnAg | Cu/Ni/SnAg Cu/SnAg | ← | ← | |
| Ball Mount | — | — | Cu/SnAg | Cu/SnAg | |
| Min. Bump Pitch /Min. Bump Size |
Copper Pillar | 80/40µm | 60/30µm | 45/25µm | 45/25µm |
| Solder Bump | 120/80µm | 100/65µm | 90/45µm | 90/45µm | |
| Ball Mount | — | — | 350/225µm | 300/150µm | |
| Max. Bump Height | Copper Pillar | 110µm | 110µm | 110µm | ← |
| Solder Bump | 85µm | 95µm | 95µm | ← | |
| RDL Process | RDL Material | Cu(+Ni/Pd/Au) | Cu(+Ni/Pd/Au) | Cu(+Ni/Pd/Au) | ← |
| Min. RDL L/S | 8/8µm | 6/6µm | 4/4µm | ← | |
| Max. RDL THK | 10µm | 12µm | 12µm | ← | |
